GIMS?氣離濺射技術(shù) 當前位置:主頁 > 技術(shù)說明 > GIMS?氣離濺射技術(shù)
GIMS:Gas Ion Source Enhanced Magnetron Sputter,氣體離子源增強磁控濺射技術(shù),分為兩種:匯聚氣離濺射(Focus GIMS)和空分氣離濺射(Separate GIMS)。
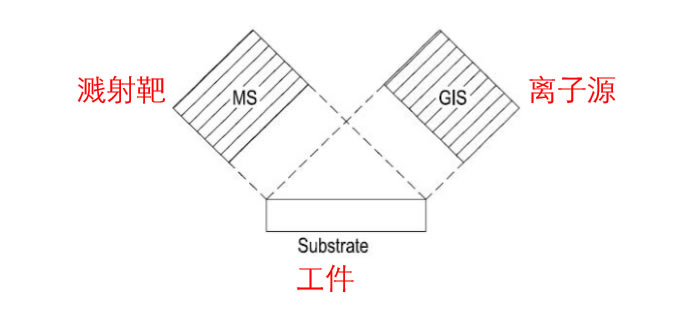

離子源的作用:
1、等離子體清洗
2、離化反應氣體
3、輔助沉積
4、抑制靶中毒
5、后離子氧化處理
匯聚氣離濺射技術(shù)
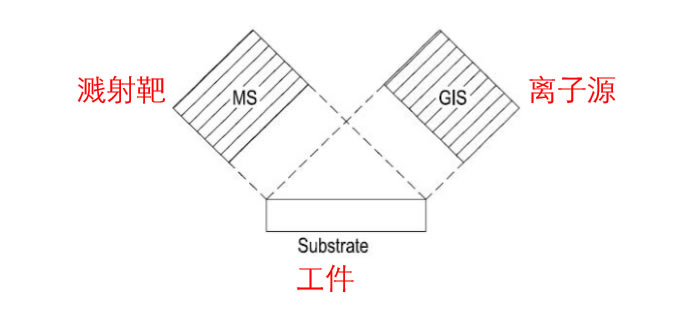
氣體離子源對反應氣體進行離化和布氣,在離子源電源電場的作用下,大量氣體離子獲得動能(溫度)飛向工件表面,產(chǎn)生轟擊作用,從而有效的增強了磁控濺射的反應離子鍍膜效應。在反應鍍膜過程中,氣體離子轟擊工件表面,表面上不穩(wěn)固的離子被轟落,膜層結(jié)構(gòu)被“夯實”,更加致密和平滑。
該技術(shù)應用在類金剛石(DLC)鍍膜中,取得了非常好的效果。
空分氣離濺射技術(shù)
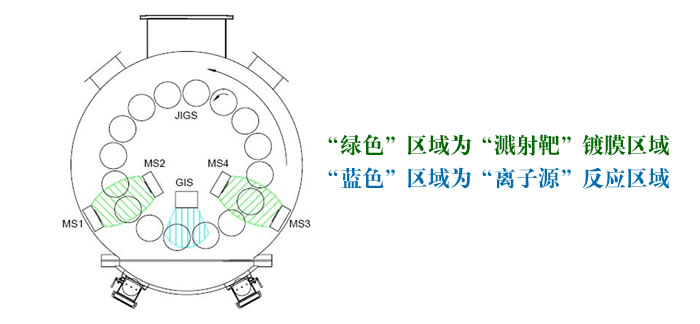
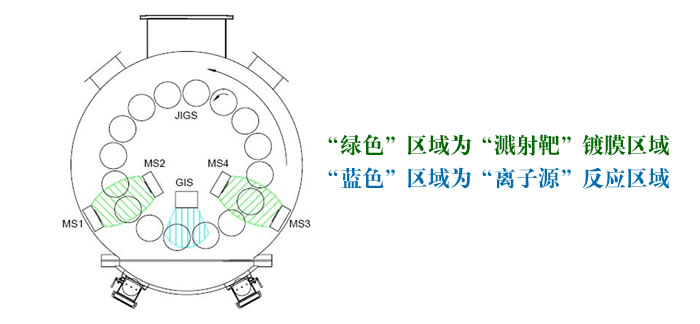
在同一氣離濺射鍍膜系統(tǒng)上,將氣體離子源的布氣方向轉(zhuǎn)離開磁控濺射靶的鍍膜區(qū)域。實現(xiàn)了磁控濺射金屬鍍膜過程和氣體離子源離化轟擊反應過程在“空間”上的分離。一個工件在通過磁控濺射對靶時涂覆金屬性膜層,再移動到氣體離子源面前時進行反應氣體離子的轟擊反應過程(如氮化),這就是所謂的空(間)分(離)氣離濺射反應離子鍍。
對于控制濺射靶的毒化有非常好的效果,使反應濺射離子鍍更加可控,鍍膜的窗口更寬。
空分氣離濺射工作狀態(tài)
空分氣離濺射工作狀態(tài)









 京公網(wǎng)安備 11010502053715號
京公網(wǎng)安備 11010502053715號