行業(yè)動(dòng)態(tài) 當(dāng)前位置:主頁(yè) > 關(guān)于丹普 > 動(dòng)態(tài)資訊 > 行業(yè)動(dòng)態(tài) >
沉積工藝參數(shù)對(duì)AlN薄膜擇優(yōu)取向影響的實(shí)驗(yàn)研究
發(fā)布時(shí)間:2022-01-18
多年前,具有低的插入損耗與高的帶外抑制的小型化高頻率器件成為研究熱點(diǎn),尤其在高頻移動(dòng)通信領(lǐng)域。聲表面波(SAW)器件有著優(yōu)良的特性在高頻通信領(lǐng)域有著廣闊的應(yīng)用前景。在制作高頻聲表面波(SAW)器件時(shí),應(yīng)用具有高聲速的材料成為解決問(wèn)題的關(guān)鍵。
從材料角度考慮,存在兩種主要方式來(lái)提高器件工作頻率。第一種為選擇高聲速的單晶壓電材料,如鈮酸鋰,氮化鋁等。第二種方式則是在高聲速襯底上生長(zhǎng)壓電材料的多層膜設(shè)計(jì),包括ZnO/sapphire,AlN/sapphire已經(jīng)被研究,其中ZnO/sapphire結(jié)構(gòu)聲速為6000m/s,這為ZnO結(jié)構(gòu)聲表面波濾波器的2倍。由于金剛石具有所有物質(zhì)中最高的彈性摸量(E=1200GPa),較低的材料密度(P=3.51g/cm3),從而聲速在所有物質(zhì)中最高。壓電材料AlN屬六方晶系,6mm點(diǎn)群,無(wú)對(duì)稱中心,具有較高的機(jī)電耦合系數(shù)、低的傳輸損耗以及良好的熱穩(wěn)定性,同時(shí),AlN薄膜的聲表面波速度是所有無(wú)機(jī)非鐵電性壓電材料中最高的。同時(shí),其溫度系數(shù)接近于零。所以AlN/diamond基片是GHz頻段聲表面波(SAW)器件的首選材料之一。
一般來(lái)說(shuō),AIN薄膜在壓電器件中的應(yīng)用多以C軸的(002)面為主,對(duì)于AlN/diamond基片上的AlN薄膜要求其結(jié)構(gòu)必須具有多晶擇優(yōu)取向,組成均勻,表面粗糙度小。在金剛石片上制備(002)面擇優(yōu)取向的A1N薄膜的研究是有重要意義的。
本文采用磁控濺射的方法,在金剛石(111)片上制備了(002)面擇優(yōu)取向的AlN薄膜。用x射線衍射的方法研究了氬氣氮?dú)獗壤R射氣壓等工藝參數(shù)對(duì)薄膜晶面取向的影響。
1、實(shí)驗(yàn)
本文采用超高真空射頻磁控濺射反應(yīng)系統(tǒng)進(jìn)行薄膜沉積。實(shí)驗(yàn)中選用鋁靶材的純度為99.999%。靶到基片的距離為65mm。工作氣體Ar和反應(yīng)氣體N2純度均為99.999%。濺射前真空室的本底真空優(yōu)于5X10-5Pa。實(shí)驗(yàn)之前首先按標(biāo)準(zhǔn)的集成電路清洗工藝處理基片,然后將基片放入進(jìn)樣室進(jìn)行原位清洗。沉積前先將擋板擋上基片,充人Ar氣,將Al靶材先預(yù)濺射15min,以除去靶面的AI2O3層,再關(guān)閉Ar氣,通人N2氣,預(yù)濺射10min,待靶的電流和電壓充分穩(wěn)定后再打開(kāi)擋板,露出基片,以保證薄膜初始沉積就有良好的取向。
薄膜的結(jié)晶取向采用日本理學(xué)公司的D/MAXⅢ一c型x射線衍射儀(Cu靶,λ=0.15418nm,40kV,150mA)來(lái)分析。
2、結(jié)果與討論
2.1 硅襯底上氮化鋁薄膜x射線衍射結(jié)果分析
本實(shí)驗(yàn)在其他工藝條件不變的情況下對(duì)不同氬氮比(14:6、10:10、8:12、4:16)對(duì)氮化鋁薄膜的取向的影響進(jìn)行了研究,并進(jìn)行了XRD測(cè)試分析。
圖1為濺射功率為75w,襯底加熱溫度為300℃時(shí),在硅襯底上生長(zhǎng)AlN薄膜的圖譜,研究了AlN薄膜的晶面擇優(yōu)取向狀況與濺射氣體氬氣與氮?dú)獗壤齈的關(guān)系圖。當(dāng)P為14:6時(shí),AlN薄膜的XRD圖譜圖1(a)上出現(xiàn)(100)面衍射峰,此時(shí)2θ=33.2℃;當(dāng)?shù)獨(dú)獗壤{(diào)高到P=10:10時(shí),(100)面衍射峰變化不明顯如圖1(b),當(dāng)?shù)獨(dú)獗壤M(jìn)一步增加為P=8:12時(shí),薄膜的XRD圖譜圖1(c)中的(100)面衍射峰消失,出現(xiàn)了(002)面衍射峰,此時(shí)2θ=36.0℃,當(dāng)?shù)獨(dú)饬髁坷^續(xù)增大時(shí),薄膜仍以(002)面擇優(yōu)取向,衍射峰強(qiáng)度逐漸增大。可以看出,隨著氮?dú)鈿鍤獗壤龃笥欣?002)面擇優(yōu)取向,隨著氮?dú)鈿鍤獗壤郎p小有利于(100)面擇優(yōu)取向。
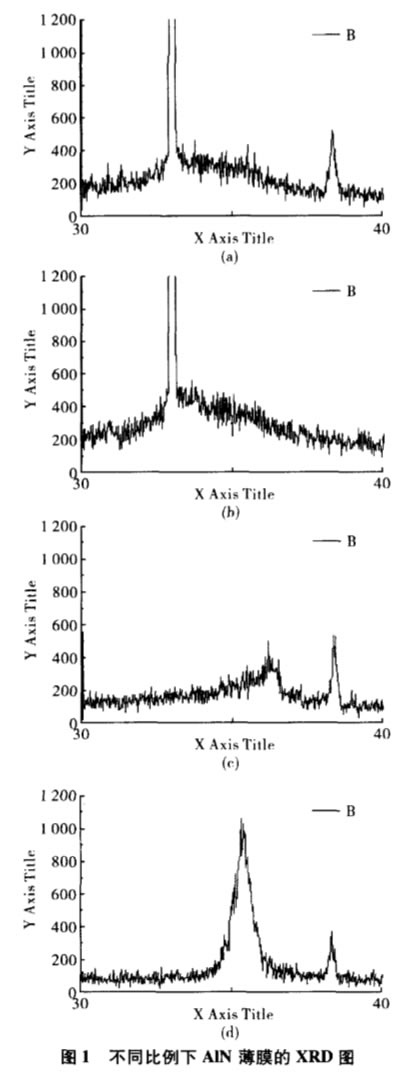
在實(shí)驗(yàn)中可同時(shí)觀察到在N2氣流量較小時(shí),濺射靶面較光亮,反應(yīng)濺射處于金屬模式,無(wú)沉積物出現(xiàn),N原子被從靶面濺射出的Al原子所消耗,靶面處于較清潔的金屬狀態(tài)。N2氣流量在增大時(shí),N2分子在氣相反應(yīng)和襯底表面的掩埋作用消耗后,尚有剩余,且在濺射氣氛中維持較低分壓,使靶面處于部分氮化狀態(tài),此時(shí)靶面有一薄層松散沉積物生成,圍繞靶心呈環(huán)形分布。隨著流量的增大,沉積物的顏色逐漸從深灰色過(guò)渡到黑色,同時(shí)靶面沉積物區(qū)域面積迅速增大,出現(xiàn)靶中毒現(xiàn)象。AkhmatorV等也觀察到了類似的靶面中毒現(xiàn)象,并推斷此沉積物就是氮化鋁(AlN)。
2.2 金剛石上氮化鋁薄膜x射線衍射結(jié)果分析
利用磁控濺射制備薄膜,工作氣壓是一個(gè)重要的實(shí)驗(yàn)參數(shù)。工作氣壓過(guò)低,氣體分子數(shù)密度過(guò)小會(huì)影響輝光放電,導(dǎo)致滅輝。工作氣壓過(guò)高,氣體分子平均碰撞幾率增大,濺射粒子的動(dòng)能降低,靶材的散射損失也增大。
同時(shí),工作氣壓是影響AlN薄膜取向生長(zhǎng)的一個(gè)重要因素。圖2為不同工作氣壓條件下在金剛石上制備的AlN薄膜的XRD圖。本實(shí)驗(yàn)中襯底溫度為300℃,Ar:N2=8:12,濺射功率100W,沉積時(shí)間180min。從圖2(a)可看出,當(dāng)工作氣壓為0.3Pa時(shí),在2θ=36.0℃存在一個(gè)衍射峰,與纖鋅礦結(jié)構(gòu)AlN的(002)峰對(duì)應(yīng)。表明在較低的工作氣壓下,AlN薄膜為(002)的擇優(yōu)取向。從0.6Pa開(kāi)始并隨工作氣壓的提高,(002)峰的衍射強(qiáng)度逐漸減弱;與此同時(shí),在33.2℃出現(xiàn)了與纖鋅礦結(jié)構(gòu)AlN的(100)峰對(duì)應(yīng)的衍射峰如圖2(c),且其強(qiáng)度隨工作氣壓的提高而增強(qiáng)。增大工作氣壓使濺射粒子的平均自由程減小,濺射粒子與氣體離子碰撞幾率加大,到達(dá)基片的粒子能量也減小。從熱力學(xué)角度來(lái)講,沉積粒子能量較小使得在基片上的形核密度變小。假設(shè)開(kāi)始沉積的原子核取向是隨機(jī)的,形核密度低可以使C軸平行于基片即(100)取向的晶粒沿著基片生長(zhǎng)很長(zhǎng)一段距離,而(002)取向的晶粒垂直基片生長(zhǎng),會(huì)因?yàn)橥怀龅木Ы缬休^大的界面能而消失,所以(100)取向的晶粒會(huì)占主導(dǎo)。當(dāng)形核密度較大時(shí),(100)取向的晶粒生長(zhǎng)時(shí)會(huì)碰到其它的晶粒而阻止其生長(zhǎng),這樣(002)取向的晶粒會(huì)占主導(dǎo)。

3、結(jié)論
采用磁控反應(yīng)濺射系統(tǒng)制備氮化鋁膜。當(dāng)濺射氣壓較低時(shí),薄膜呈(002)擇優(yōu)取向。氮?dú)獗壤脑黾佑欣贏IN(002)取向的生長(zhǎng)。相反氮?dú)獗壤档蜁r(shí),薄膜呈(100)擇優(yōu)取向。
作者:盧 勤 ,李化鵬 ,陳希明
聲明:本站部分圖片、文章來(lái)源于網(wǎng)絡(luò),版權(quán)歸原作者所有,如有侵權(quán),請(qǐng)點(diǎn)擊這里聯(lián)系本站刪除。
| 返回列表 | 分享給朋友: |








 京公網(wǎng)安備 11010502053715號(hào)
京公網(wǎng)安備 11010502053715號(hào)